
トップページ > CAE ソリューション > Nitride MOVPE-database > GaN解析実績②
MOVPE-Database Menu
解析事例
- GaN フルスペックモデル
解析実績 ① - GaN フルスペックモデル
解析実績 ② - GaN フルスペックモデル
活用事例 - AlN, AlGaN フルスペック
モデル解析実績 ① - InGaN フルスペックモデル
活用事例
窒化物MOVPE成長 反応データベース

GaN 成長(フルスペックモデル)の解析実績②
公表論文 (本事例紹介の内容は、下記の論文より引用しています。)
- 大川和宏, 平子晃, 徳田耕太, 真空, Vol.49, No.9, 520 (2006).
GaN 成長モデル(フルスペックモデル)を利用した事例として、大型装置の3次元解析を紹介します。
1. 6インチ5枚型 MOVPE装置
図1のような 6 インチ(150 mm)基板 5 枚を搭載するような MOVPE 装置を想定しています。
装置の大型化に伴う検討項目は多岐に亘りますが、ここでは温度分布と原料供給の均一性について検討しています。大型の基板面における GaN の均一な結晶成長および品質の保持には、流れ場の乱れを抑制し温度の均一性を保つこと、また十分に基板全面に原料ガスが供給されることが求められます。
2. 計算モデル
使用データベース:GaN成長(フルスペック)モデル・熱解析データ計算ソルバー:CFD-ACE+
上記の目的を達成するために、装置天井部の構造に着目しています。図2 のような平行平板型と傾斜型の二種類の3次元モデルにおいて、GaN の均一性を検討します。
原料ガス流量は、ガス1:TMGa = 1.35 mmol/min, NH3 = 24 slm, H2 = 144 slm 、ガス2:H2 = 306 slm、ガス3:N2 = 80 slm。ガス入り口におけるこれらのガスは300K, 100 kPa です。
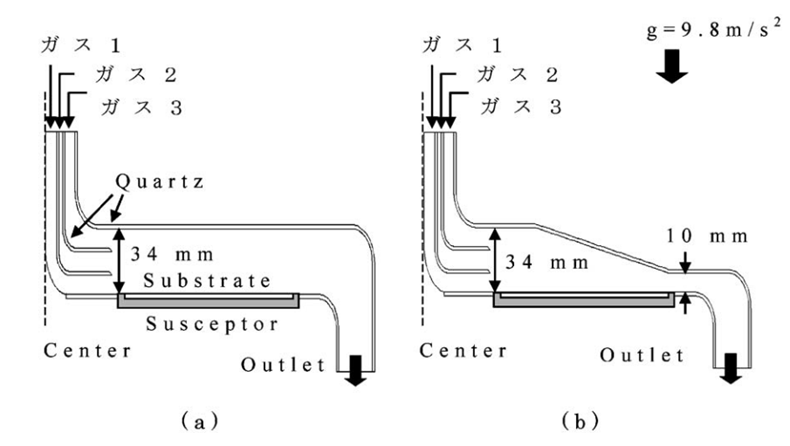
図2 (a)平行平板型リアクターの断面図、(b)傾斜型リアクターの断面図
※ クリックで拡大表示
3. 計算結果① 流れ場の様子
図3 に基板中心断面における流れの方向を示します。平行平板型では、基板入り口で熱対流によるガスの上昇が生じ、この空白部を埋めるために回転循環の流れが基板上流側に生じます。さらに、基板中腹部では基板の横方向からの流れ込みが乱れを生じさせていることが確認されます。この様に、平行平板型では熱対流に伴う流れの乱れが制御できないことが予測できます。一方で、傾斜型では、傾斜により下流側においても適度なガス流速が得られるため、熱対流が抑えられ乱れが抑制されていることが確認されます。
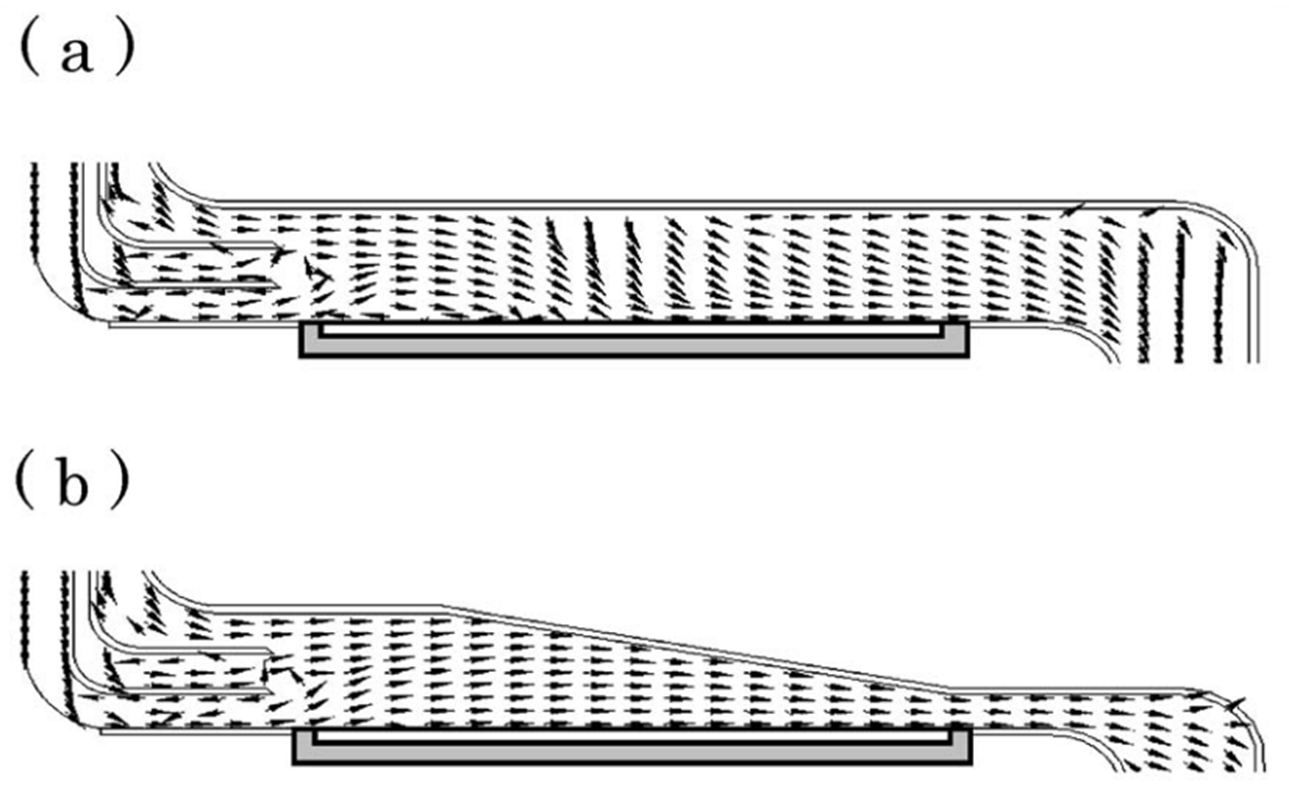
図3 (a)平行平板型、(b)傾斜型リアクター断面の流れ場の様子
※ クリックで拡大表示
4. 計算結果② GaN 成長速度分布
図4 に基板中央線に沿った GaN 成長速度分布を示します。平行平板型では上流50 mm 過ぎに成長速度が激減し、流れ場の影響を受けていることが示唆されます。一方傾斜型では、上流側の基板端を除いて緩やかな傾斜分布を持つ成長速度が得られることが確認されます。
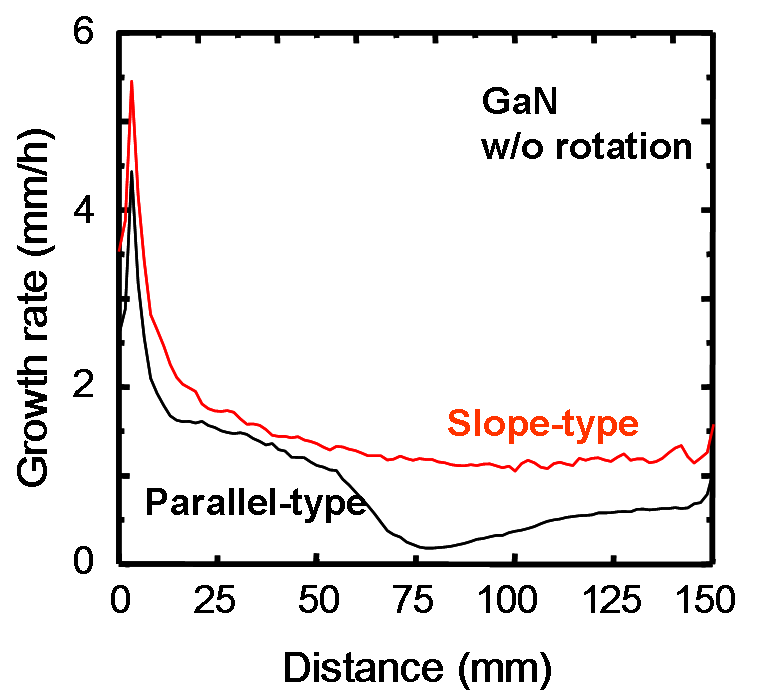
図4 基板の中央線に沿った GaN 成長速度分布
※ クリックで拡大表示


