
Plasma
 炭素とフッ素によるプラズマ処理
炭素とフッ素によるプラズマ処理
半導体産業が、機能サイズを縮小してデバイスの性能を改善していくにつれて、 新しいデバイス構造でより小さい構造が処理されるようになり、 エッチング処理の課題はより難しくなっていきます。 より高密度で、よりアスペクト比の大きい構造は、 ウエハー処理の複数の分野での一層の革新を必要とする、新しい課題をもたらします。 この複雑さにより、これらの革新は、 プラズマのエッチング過程の包括的な物理、化学、そして計算モデルに、より一層依存するようになってきました。
プラズマエッチングは、半導体の製造で、物質を表面から除去するために使われる重要な工程です。 表面から物質を非等方的に取り除くための、商業的に実現可能な唯一の技術となっています。 プラズマは、1980年代の中ごろに、ナノ電気の製造プロセスに導入され、 トランジスターの大きさは、1マイクロメートルから今日の約0.01マイクロメートルまで、ほぼ二けた縮小しましたが、 その過程は試行錯誤で進んできました。 残念ながら、プラズマエッチングの過程の詳細なメカニズムは、多くのプロセス気体で、まだ十分に理解されていません。 ですから、これらのメカニズムの開発、改善、そして実証は努力を要し続けています。 この分野での革新の好機が開かれています。
Wafer
 原子の詳細を最後まで
原子の詳細を最後まで
エッチングの、増大していく費用が、密度と処理速度の改善を遅らせようとしています。 しかし、製造費用はシミュレーションツールを用いて軽減することができます。 デバイスのそれぞれの世代は、より多くの層、より多くのパターン作成、そしてより多くのパターン作成のサイクルを必要として、 全体の費用と複雑さを増加させ続けます。 構成部品をより小さくすることができても、それにより、より精細なリトグラフィーとエッチング装置を開発する追加費用が、製造業者に課されます。 注目点は、大容積での原子層の処理と、ムーアの法則を延長するための小型化の新しいアプローチとのバランスです。
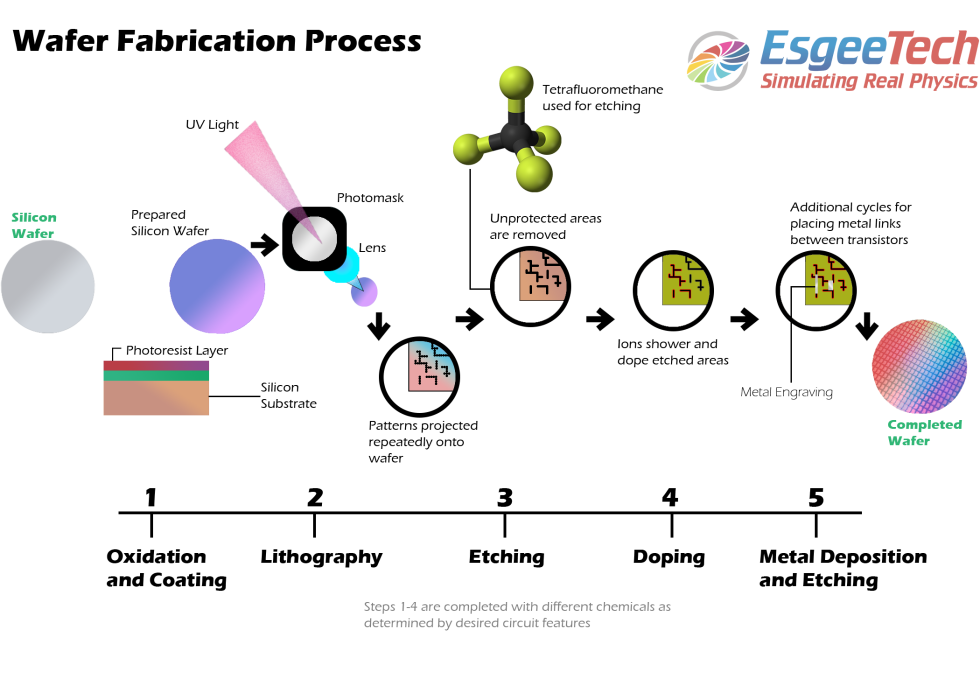
ウエハーの製造プロセス
プラズマエッチングは、ウエハー製造の工程の一部で行われます。 それは今度は、半導体製造工程の主要なプロセスとなります。 ウエハーが完成するには、サイクルを異なった化学物質で、潜在的には数百回、完遂させる必要があります。 それぞれのサイクルは、層の数と、目的の回路がもたらす機能を増加させます。
ウエハーは最初は、純粋で、導電性のない、薄いシリコンの円盤で、直径は 6~12インチ (14.7~29.4 cm)です。 これらのウエハーは、結晶シリコンでできていて、 酸化とコーティングができるようになるまで、化学的に純粋になるように、非常に注意されています。 酸化は、半導体製造の最も古いステップの一つで、1950年代から使われています。 シリコンは酸素への親和力が強く、酸素はすぐに吸収されて、酸化物を横切って輸送されます。 フォトレジスト ——酸化物へのエッチングのためのマスク—— が塗られる前に、 絶縁体の層と、導電性物質の層がウエハーにコートされます。 フォトレジストは、紫外線にさらされると溶ける物質に変わり、さらされた面は溶媒で溶かされます。 その結果残ったパターンで、エッチングやドーピングのようなデバイスを製造するときの後の工程を、エンジニアがコントロールできるようになります。 集積回路のパターンはまず、光を通過させる穴や透明な部分があるガラスや水晶の板に転写され、複数の板は回路のそれぞれの層をマスクします。 次に、先に述べた紫外線が、フォトレジスト物質のコーティングからからウエハーへとパターンを転写するために照射されます。 そして、フォトレジストの化学物質がエッチングの前に除去されます。 ここで、 物質をウエハーから除去する化学反応を作り出すための供給ガス ——窒素のような輸送する気体と、そのほかの反応性の気体とを混合した気体—— の気流が導入されます。
エッチングの過程で、フォトレジストに守られていない面は、化学的に除去されます。 エッチングは一般には物質の除去のことを言いますが、フォトマスクの層と、その下の物質とに影響しないことも要求されます。 いくつかの場合には、非等方的なエッチングなどで、物質が特定の方向の除去されて鋭い角や平たい面などの形状特徴を作り出されます。 これは、エッチングのレートを増やし、サイクルの時間を減らします。 金属の堆積とエッチングは、トランジスターの間の金属の接合を設置することを含み、これがウエハー完成の前の最後のステップの一つです。
エッチングの過程には、物理的な特質と、化学的な特質があります。 活性化学種(原子、イオン、ラジカル)は、供給気体の、電子衝突の電離反応で生成されます。 プラズマエッチングのための混合気体は、エッチング率や、マスクとその下の層との選択性や、非等方性への要求が対立するため、通常は複雑です。 また、プラズマ自体も供給気体を、気相や表面で互いに反応ができる反応性の化学種へと分解します。 それが、プラズマ中でのさらなる化学種生成を引き起こします。
もっとも一般的なエッチングのための原子(エッチャント)は、フッ素、塩素、臭素、そして酸素です。 これらは通常、化学的に反応しやすい気体、 例えば CF4, O2, Cl2, CCl2, HBr, そして CHCl3 などの混合気体から生成されます。 誘導結合プラズマ(ICP)と、容量結合プラズマ(CCP)の反応装置は、半導体製造で、最も広範囲に用いられています。 ICPのプラズマ源は、比較的低い気体の圧力(1~10 mTorr)で、 比較的高い密度のプラズマ(1016~1017 m-3)の生成ができます。 ウエハーのバイアスを独立させると、 ウエハー表面でのイオンのフラックスとイオンのエネルギーの独立したコントロールが可能になります。 この過程は、異なる物質を異なるレートでを取り除くため、化学的に選択性があるように設計することができます。
Molecule
 分子のデザインを考えて
分子のデザインを考えて
プラズマエッチングの最も重要な適用分野は、 パターンのついたシリコンやポリシリコンの薄膜の、選択的で非等方な除去です。 ハロゲン原子のエッチャント(フッ素、塩素、臭素)に関連した前駆体の供給気体は、 ほぼいつも、この目的のために使われます。 フッ素原子のための一般的な供給気体は、 CxF, SF6, そして NF3です。 反応性プラズマでの、物理的な、また、化学的なプロセスを理解することは、 信頼できる、基礎的な有限反応レートの化学反応メカニズムを必要とします。 四フッ化炭素(CF4)は、フッ素原子の生成のために最もよく使われる気体の一つです。 CF4のプラズマに、ごく少量の酸素を混ぜることで、 シリコン表面のエッチングレートが劇的に増加し、また、シリコンの横方向のエッチングのコントロールに使うこともできます。
ICP
 ICP反応器での電子温度の分布をVizGlow™でモデル化します
ICP反応器での電子温度の分布をVizGlow™でモデル化します
四フッ化炭素(CF4)は、シリコンのプラズマエッチングのための重要な供給気体です。 比較的取り扱いが易しく、腐食性が無く、毒性が低いです。 CF4 は、安定な電子状態がありません。 これは、電子の励起のロスが無く、 電子のエネルギーが化学的に活性のイオンやラジカルの生成に用いられることを意味します。 プラズマエッチングプロセスの初期開発から研究されてきた四フッ化炭素ですが、 多様な気相反応と表面反応の、活性化学種の密度への影響は、いまだにあまり理解されていません。

VizGlow™で求めた、ICP反応装置の中の電子温度分布
VizGlow™は、化学的に反応性のプラズマをモデル化するための、完全な機能を備えた、現象に忠実なシミュレーションツールです。 反応性プラズマは、ここまでに述べた、半導体製造プロセスでおこなわれるステップの半分で存在します。 気体の化学種の特性と、その反応の動力学的モデリングは、 まだ探求されていないさらなる革新の可能性がある分野でありつづけています。 プラズマによって作り出される活性種は、ペアになっていない電子があるため非常に反応性が高いです。 半導体エンジニアはプロセスとサイクルタイムを高速にするために、そのような活性種を使います。 同じことが、堆積過程でも言えます。 エッチング装置内で作り出される、1000℃を超える温度から冷却するので、 活性種はチップへの損傷を予防します。 これらのプロセスを通して、 シミュレーションモデルの助けを借りて、欠陥、不純物、そして非均一性を検出することができ、診断することができます。 VizGlow™によるシミュレーションは、 プロセスを何カ月も続けた後でも、ウエハーが損傷するような運用条件を避けるように、繰り返しをデザインすることを助けます。
Paper
 論文
論文
ここまでお読みいただきありがとうございました。参考論文を以下に示します。
- D. Levko, C. Shukla, R.R. Upadhyay, L.L. Raja, “Computational study of plasma dynamics and reactive chemistry in a low-pressure inductively coupled CF4/O2 plasma,” Journal of Vacuum Science & Technology B 39, 042202 (2021), https://doi.org/10.1116/6.0001028
- Levko, Dmitry, Chandrasekhar Shukla, and Laxminarayan L. Raja. “Modeling the effect of stochastic heating and surface chemistry in a pure CF4 inductively coupled plasma.” Journal of Vacuum Science & Technology B, Nanotechnology and Microelectronics: Materials, Processing, Measurement, and Phenomena 39.6 (2021): 062204. https://doi.org/10.1116/6.0001293
- Levko, Dmitry, et al. “Plasma kinetics of c-C4F8 inductively coupled plasma revisited.” Journal of Vacuum Science & Technology B, Nanotechnology and Microelectronics: Materials, Processing, Measurement, and Phenomena 40.2 (2022): 022203. https://doi.org/10.1116/6.0001631
- Lee, Chris GN, Keren J. Kanarik, and Richard A. Gottscho. “The grand challenges of plasma etching: a manufacturing perspective.” Journal of Physics D: Applied Physics 47.27 (2014): 273001.
- Kanarik, Keren J. “Inside the mysterious world of plasma: A process engineer's perspective.” Journal of Vacuum Science & Technology A: Vacuum, Surfaces, and Films 38.3 (2020): 031004. https://doi.org/10.1116/1.5141863
- Marchack, N., et al. “Plasma processing for advanced microelectronics beyond CMOS.” Journal of Applied Physics 130.8 (2021): 080901. https://doi.org/10.1063/5.0053666
